QR kood

Meie kohta
Tooted
Võta meiega ühendust


Faks
+86-579-87223657

E-post

Aadress
Wangda Road, Ziyang Street, Wuyi maakond, Jinhua linn, Zhejiangi provints, Hiina
Pooljuhtide ja FPD-paneelide kuvarite puhul on õhukeste kilede ettevalmistamine oluline protsess. Õhukeste kilede (TF, õhuke kile) valmistamiseks on palju võimalusi, levinud on kaks järgmist meetodit:
● CVD (keemiline aurustamine-sadestamine)
● PVD (füüsiline aurude sadestumine)
Nende hulgas ladestub puhverkiht/aktiivne kiht/isoleerikiht masinakambrisse, kasutades PECVD -d.
● Kasutage spetsiaalseid gaase: SIH4/NH3/N2O SIN ja SI/SiO2 filmide sadestamiseks.
● Mõned CVD-masinad peavad kandja liikuvuse suurendamiseks kasutama hüdrogeenimiseks H2.
● NF3 on puhastusgaas. Võrdluseks: F2 on väga toksiline ja SF6 kasvuhooneefekt on suurem kui NF3 oma.
Pooljuhtide seadme protsessis on lisaks tavalisele SiO2/Si/Sin -le ka rohkem õhukesi kileid, seal on ka W, TI/TIN, HFO2, SIC jne.
See on ka põhjus, miks pooljuhtide tööstuses kasutatavate kõrgtehnoloogiliste materjalide jaoks kasutatakse erinevat tüüpi õhukeste kilede valmistamiseks mitmesuguseid lähteaineid.
1. CVD tüübid ja mõned eelkäijad gaasid
2. CVD ja filmikvaliteedi põhimehhanism
CVD on väga üldine kontseptsioon ja seda saab jagada paljudeks tüüpideks. Tavalised on:
● Pecvd: Plasma täiustatud CVD
● LPCVD: madalrõhu CVD
● ALD: aatomkihi ladestumine
● Mocvd: Metall-orgaaniline CVD
CVD protsessi ajal tuleb enne keemilisi reaktsioone eelkäija keemilisi sidemeid purustada.
Energia keemiliste sidemete purustamiseks tuleb kuumusest, seega on kambri temperatuur suhteliselt kõrge, mis ei ole mõne protsessi jaoks sõbralik, näiteks paneeli alusklaas või painduva ekraani PI-materjal. Seetõttu, kui sisestate protsessi temperatuuri vähendamiseks muud energiat (moodustades plasma jne), et see vastaks teatud protsessidele, mis nõuavad temperatuuri, väheneb ka soojuseelarve.
Seetõttu kasutatakse A-SI PECVD sadestumist: H/sin/polü-Si kasutatakse laialdaselt FPD väljatööstuses. Levinud CVD eelkäijad ja filmid:
Polükristalliline räni/üksikkristall räni SiO2 sin/sion w/ti wsi2 hfo2/sic
CVD põhimehhanismi etapid:
1. Reaktsiooni lähtegaas siseneb kambrisse
2. Gaasreaktsioonil tekkivad vahesaadused
3. gaasi vaheproduktid hajuvad substraadi pinnale
4. Adsorbeeritud substraadi pinnale ja hajutatud
5. Substraadi pinnal toimub keemiline reaktsioon, tuumade moodustumine / saare moodustumine / kile moodustumine
6. Kõrvalsaadused desorbeeritakse, vaakumpumbatakse ära ja tühjendatakse pärast puhastusseadmesse sisenemist töötlemiseks
Nagu varem mainitud, sisaldab kogu protsess mitmeid etappe, nagu difusioon/adsorptsioon/reaktsioon. Üldist kile moodustumise kiirust mõjutavad paljud tegurid, nagu temperatuur / rõhk / reaktsioonigaasi tüüp / substraadi tüüp. Difusioonil on ennustamiseks difusioonimudel, adsorptsioonil adsorptsiooniteooria ja keemilisel reaktsioonil reaktsiooni kineetika teooria.
Kogu protsessis määrab kõige aeglasem samm kogu reaktsioonikiiruse. See on väga sarnane projektijuhtimise kriitilise tee meetodiga. Pikim tegevusvoog määrab projekti lühima kestuse. Kestust saab lühendada, eraldades selle tee aja vähendamiseks ressursse. Sarnaselt võib CVD leida võtme kitsaskoha, mis piirab kile moodustumise kiirust, mõistes kogu protsessi, ja kohandada parameetri sätteid, et saavutada ideaalse kile moodustumise kiirus.
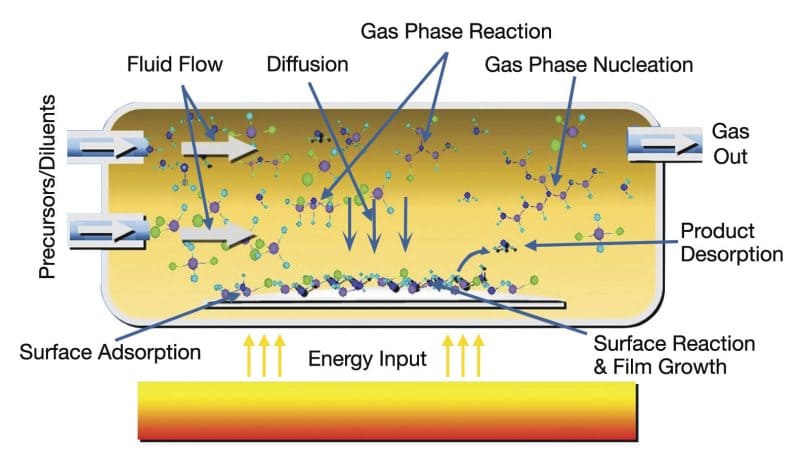
Mõned kiled on lamedad, mõned on augutäidisega ja mõned on soonte täitmisega, millel on väga erinevad funktsioonid. Kommertslikud CVD -masinad peavad vastama põhinõuetele:
● Masina töötlemismaht, sadestumise määr
● Järjepidevus
● Gaasifaasi reaktsioonid ei saa tekitada osakesi. On väga oluline, et gaasifaasis ei tekiks osakesi.
Mõned muud hindamisnõuded on järgmised:
● Hea sammu katvus
● Võimalus täita kõrge kuvasuhte lüngad (vastavus)
● Hea paksuse ühtlus
● Suur puhtus ja tihedus
● Kõrge struktuurne täiuslikkus ja madal kile pinge
● Head elektrilised omadused
● Substraadimaterjali suurepärane haardumine



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi maakond, Jinhua linn, Zhejiangi provints, Hiina
Autoriõigus © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Kõik õigused kaitstud.
Links | Sitemap | RSS | XML | Privaatsuspoliitika |
