QR kood

Meie kohta
Tooted
Võta meiega ühendust


Faks
+86-579-87223657

E-post

Aadress
Wangda Road, Ziyang Street, Wuyi maakond, Jinhua linn, Zhejiangi provints, Hiina
Räni karbiidi substraatidel on palju defekte ja neid ei saa otse töödelda. Kipi vahvlite valmistamiseks tuleb neil epitaksiaalse protsessi kaudu kasvatada konkreetset üksikkristall -õhukest kilet. See õhuke kile on epitaksiaalne kiht. Peaaegu kõik räni karbiidiseadmed on epitaksiaalsetel materjalidel realiseeritud. Räni karbiidiseadmete väljatöötamise aluseks on kvaliteetsed räni karbiidi homogeensed epitaksiaalsed materjalid. Epitaksiaalsete materjalide jõudlus määrab otseselt räni karbiidiseadmete jõudluse.
Kõrgvoolu ja ülitugevusega räni karbiidiseadmed on esitanud rangemad nõuded epitaksiaalsete materjalide pinna morfoloogiale, defektide tihedusele, dopingule ja paksusele ühtlusele. Suure suurusega, madala defekti tihedus ja ülitähtsusräni karbiidi epitaksiaon saanud räni karbiidi tööstuse arendamise võti.
Kvaliteetse ettevalmistamineräni karbiidi epitaksianõuab täiustatud protsesse ja seadmeid. Kõige laialdasemalt kasutatav räni karbiidi epitaksiaalne kasvumeetod on keemiline aurude ladestumine (CVD), millel on eelised epitaksiaalse kile paksuse ja dopingukontsentratsiooni täpse kontrolli, vähem defekte, mõõdukat kasvukiirust ja automaatset protsesside kontrolli. See on usaldusväärne tehnoloogia, mida on edukalt turustatud.
Ränikarbiid CVD epitaksia kasutab tavaliselt kuuma seina või sooja seina CVD-seadmeid, mis tagab epitaksiaalse kihi 4H Crystal SIC jätkamise kõrgema kasvutemperatuuri tingimustes (1500-1700 ℃). Pärast aastatepikkust arengut saab kuuma seina või sooja seinaga CVD jagada horisontaalseks horisontaalstruktuuri reaktoriteks ja vertikaalseteks vertikaalsete struktuurireaktoriteks vastavalt sisendi gaasi voolu ja substraadi pinna suunale.
Räni karbiidi epitaksiahju kvaliteedil on peamiselt kolm näitajat. Esimene on epitaksiaalse kasvu jõudlus, sealhulgas paksuse ühtlus, dopingu ühtlus, defektide määr ja kasvukiirus; Teine on seadme enda temperatuuri jõudlus, sealhulgas kütte-/jahutuskiirus, maksimaalne temperatuur, temperatuuri ühtlus; ja lõpuks seadme enda kulude, sealhulgas ühiku hind ja tootmisvõimsus.
Kuuma seina horisontaalne CVD, soe seinaplaneetiline CVD ja kvaasi kuum sein vertikaalne CVD on peavoolu epitaksiaalse seadme tehnoloogialahendused, mida selles etapis on kaubanduslikult rakendatud. Kolmel tehnilisel seadmel on ka oma omadused ja neid saab valida vastavalt vajadustele. Konstruktsiooniskeem on näidatud alloleval joonisel:

Kuuma seina horisontaalne CVD-süsteem on üldiselt ühe õhuga suures kasvusüsteem, mida juhib õhu ujutamine ja pöörlemine. Heade indikaatorite saavutamine on lihtne saavutada. Esindusmudel on Itaalia LPE Company Pe1O6. See masin suudab vahvlite automaatse laadimise ja mahalaadimise 900 ℃ juures realiseerida. Peamised omadused on kõrge kasvutempo, lühike epitaksiaalne tsükkel, hea järjepidevus vahvli sees ja ahjude vahel jne. Sellel on Hiinas kõrgeim turuosa.

LPE ametlike aruannete kohaselt koos peamiste kasutajate kasutamisega võib 100–150 mm (4–6 tolli) 4H-sic epitaksiaalse vahvli toodete paksusega vähem kui 30 μm toodetud PE1O6 epitaksiahju paksusega saavutada stabiilselt järgmised indikaatorid: intra-defert ≤2%, intra-wafer ≤2%, intra-defert-intravektsioonikontsembsioonid järgmised indikaatorid: ≤1 cm-2, pinna defektivaba pindala (2mm × 2mm ühikuelement) ≥90%.
Kodumaised ettevõtted nagu JSG, CETC 48, Naura ja NASO on välja töötanud monoliitsete räni karbiidi epitaksiaalseid seadmeid, millel on sarnased funktsioonid ja on saavutanud suuremahulised saadetised. Näiteks vabastas JSG veebruaris 2023 6-tollise topelt-wafer sic-epitaksiaalse seadme. Seadmed kasutavad reaktsioonikambri grafiidosade ülemise ja alumise kihti ülemist ja alumist kihti, et kasvatada kahte epitaksiaalset vahvlit ühes ahjus ning ülemist ja alumist protsessigaasi saab eraldi reguleerida, temperatuuri erinevuse ≤5 ° C -ga, mis moodustab tõhusalt monoliitilise horisontaalse epitaxiaxi ebapiisava tootmisvõimaluse ebasoodsate tootmisvõimsuse.SIC -katte poolamoonosad.Me varustame kasutajatele 6 -tolliseid ja 8 -tolliseid poolaja osi.

Sooja seinaga planeedi CVD-süsteemi, millel on aluse planeedi paigutus, iseloomustab mitme vahvli kasv ühe ahju ja suure väljundi efektiivsusega. Esinduslikud mudelid on AIXG5WWC (8x150mm) ja G10-SIC (9 × 150mm või 6 × 200 mm) seeria epitaksiaalsed seadmed Saksamaa Aixtronist.
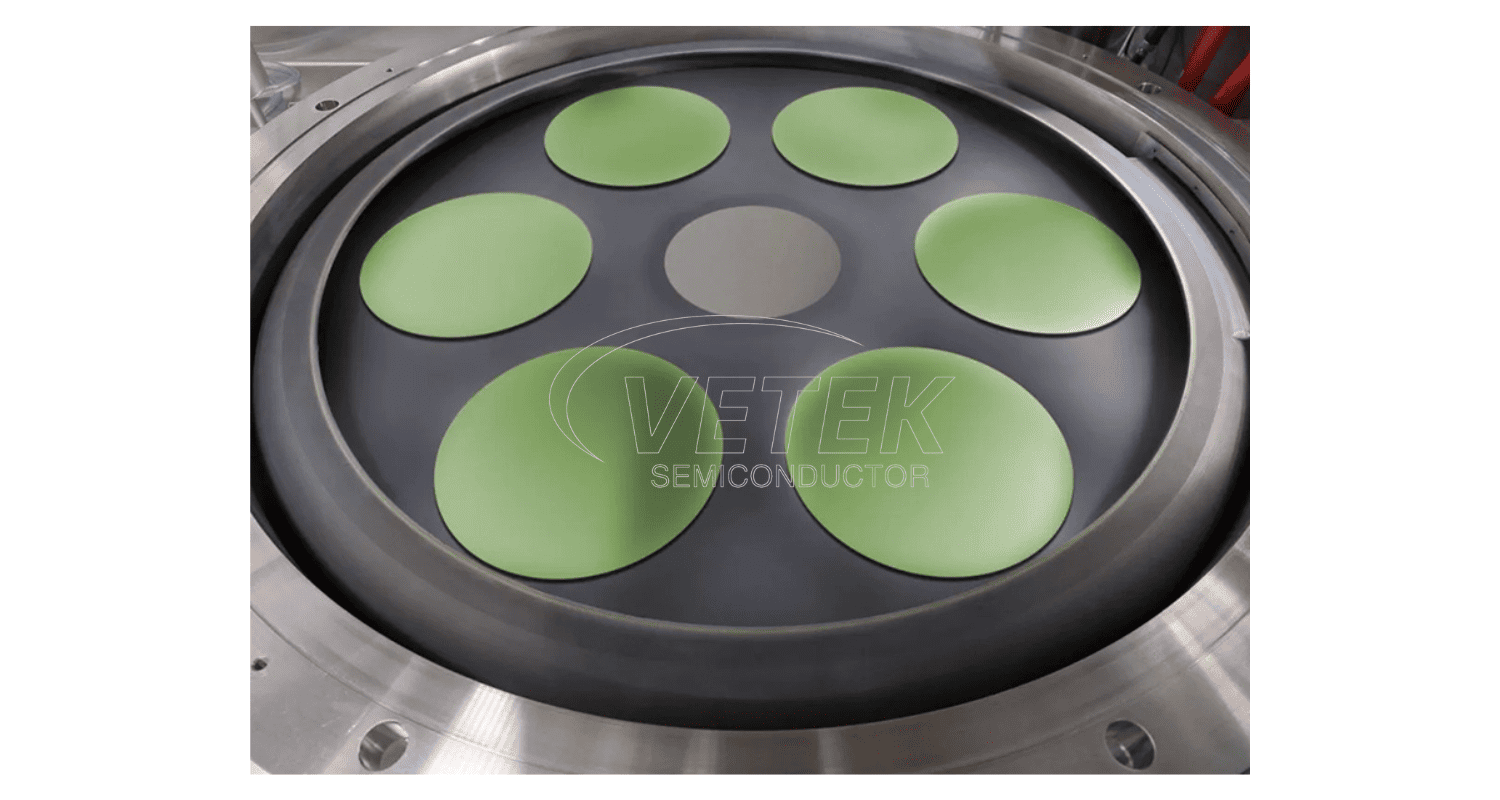
Aixtroni ametliku raporti kohaselt suudab 6-tollised 4H-SIC epitaksiaalsed vahvlid tooted, mille paksus on 10 μM, toodetud G10 epitaksiaalse ahjuga, saavutada stabiilselt järgmised indikaatorid: nakatunud epitaksiaalse paksuse ± 2,5%-lise epitaksiaalse paksuse hälbe ± 2,5%, intraksiaalse paksusega, 2%-line infotehnoloogia, mis on ebaühtlane, 2%-line. kontsentratsioon ebaühtlus <2%.
Siiani kasutavad seda tüüpi mudelit kodumaised kasutajad harva ja partii tootmise andmed ei ole piisavad, mis teatud määral piirab selle insenerirakendust. Lisaks on mitme hakavate epitaksiaalsete ahjude kõrgete tehniliste tõkete tõttu temperatuurivälja ja vooluvälja juhtimise osas sarnaste kodumaiste seadmete arendamine endiselt uurimis- ja arendustegevuses ning puudub alternatiivne mudel. Vahepeal võime pakkuda Aixtroni planeedi vastuvõtjat nagu 6-tolline ja 8-tolline kattega kaasnev või sic Coating.
Kvaasi-kuuma seina vertikaalne CVD-süsteem pöörleb peamiselt suurel kiirusel läbi välise mehaanilise abi. Selle omadus on see, et viskoosse kihi paksust vähendab tõhusalt madalam reaktsioonikambri rõhk, suurendades sellega epitaksiaalset kasvukiirust. Samal ajal pole selle reaktsioonikambril ülemist seina, millele SIC -osakesi saab ladestada, ja langevate objektide tootmine pole kerge. Sellel on defektide kontrollimisel loomupärane eelis. Esinduslikud mudelid on Jaapani NUFLARE üheprotsesside epitaksiaalsed ahjud EPIREVOS6 ja EPIREVOS8.
NUFLARE andmetel võib Epirevos6 seadme kasvukiirust ulatuda üle 50 μm/h ja epitaksiaalse vahvli pinna defekti tihedust saab juhtida alla 0,1 cm-²; Ühtsuse kontrolli osas teatas NUFLARE insener Yoshiaki Daigo 10 μm paksuse 6-tollise epitaksiaalse vahvli, mida kasvatatakse Epirevos6 abil, ja nakatuva paksuse ja dopingusisese kontsentratsiooniga ebaühtlasena, mis saavutasid vastavalt 1% ja 2,6% -ni. Meil on SIC-i kõrged graafilised osad.Ülemine grafiidisilinder.
Praegu on sellised kodumaised seadmed, nagu kolmas põlvkond ja JSG, kavandanud ja käivitanud sarnaste funktsioonidega epitaksiaadmed, kuid neid pole suures mahus kasutatud.
Üldiselt on kolmel tüüpi seadmetel oma omadused ja need on teatud turuosa erinevates rakenduste vajadustes:
Kuumal seina horisontaalsel CVD-struktuuril on ülipopulaarne kasvukiirus, kvaliteet ja ühtlus, lihtne seadmete töö ja hooldus ning küpsed suuremahulised tootmisrakendused. Kuid ühe töötava tüübi ja sagedase hoolduse tõttu on tootmise efektiivsus madal; Soe seinaplaneetide CVD võtab üldiselt kasutusele 6 (tüki) × 100 mm (4 tolli) või 8 (tükk) × 150 mm (6 tolli) aluse struktuur, mis parandab seadme tootmise tõhusust oluliselt tootmisvõimsuse osas, kuid mitme tüki konsistentsi on keeruline kontrollida ja tootmissaak on endiselt suurim probleem; Kvaasi-kuuma seina vertikaalsel CVD-l on keeruline struktuur ja epitaksiaalse vahvli tootmise kvaliteedidefektide kontroll on suurepärane, mis nõuab äärmiselt rikkalikku seadmete hooldamist ja kasutamist.
Kiire kasvutempo
lihtne seadme struktuur ja
mugav hooldus
Suur tootmisvõimsus
tootmise kõrge efektiivsus
Hea toote defekti kontrollimine
pikk reaktsioonikamber
hooldustsükkel
Keeruline struktuur
Raske kontrollida
toote järjepidevus
Kompleksseadme struktuur,
keeruline hooldus
Esinduslik
varustus
tootjad
Kuum seina horisontaalne CVD
Soe seinaplaneetide cwd
Kvaas-kuuma seina vertikaalne CTD
Eelised
Puudused
Lühike hooldustsükkel
Itaalia LPE, Jaapan Tel
Saksamaa Aixtron
Jaapan nuflare
Tööstuse pideva arendamise korral optimeeritakse neid kolme tüüpi seadmeid iteratiivselt ja uuendatakse struktuuri osas ning seadmete konfiguratsioon muutub üha täiuslikumaks, mängides olulist rolli erinevate paksuste ja defektnõuetega epitaksiaalsete vahvlite spetsifikatsioonide sobitamisel.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi maakond, Jinhua linn, Zhejiangi provints, Hiina
Autoriõigus © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Kõik õigused kaitstud.
Links | Sitemap | RSS | XML | Privaatsuspoliitika |
