QR kood

Meie kohta
Tooted
Võta meiega ühendust


Faks
+86-579-87223657

E-post

Aadress
Wangda Road, Ziyang Street, Wuyi maakond, Jinhua linn, Zhejiangi provints, Hiina
RakendatavTAC-kattega grafiidiosadüksikkristalliahjudes
OSA/1
SiC ja AlN monokristallide kasvatamisel füüsilise aurutranspordi (PVT) meetodil on üliolulised komponendid, nagu tiigel, seemnehoidja ja juhtrõngas, ülioluline. Nagu on kujutatud joonisel 2 [1], asetatakse PVT protsessi ajal algkristall madalama temperatuuriga piirkonda, samal ajal kui ränikarbiidi tooraine puutub kokku kõrgemate temperatuuridega (üle 2400 ℃). See viib toormaterjali lagunemiseni, tekitades SiXCy ühendeid (peamiselt Si, SiC₂, Si2C jne). Seejärel transporditakse aurufaasi materjal kõrge temperatuuriga piirkonnast madala temperatuuriga piirkonna idukristallidele, mille tulemuseks on idutuumade moodustumine, kristallide kasv ja üksikute kristallide teke. Seetõttu peavad selles protsessis kasutatavad soojusvälja materjalid, nagu tiigel, voolujuhtrõngas ja seemnekristallide hoidja, olema kõrgel temperatuuril vastupidavad, saastamata ränikarbiidi toorainet ja monokristalle. Sarnaselt peavad AlN kristallide kasvatamisel kasutatavad kütteelemendid taluma Al-auru ja N2 korrosiooni, omama samal ajal ka kõrget eutektilist temperatuuri (koos AlN-ga), et vähendada kristallide ettevalmistamise aega.
On täheldatud, et SIC [2-5] ja ALN [2-3] ettevalmistamiseks TAC-kattega grafiidiga termiliste välimaterjalide kasutamine põhjustab puhtamaid tooteid minimaalse süsinikuga (hapnik, lämmastik) ja muud lisandid. Nendel materjalidel on igas piirkonnas vähem servadefekte ja madalam takistus. Lisaks väheneb mikropooride tihedus ja söövituskihi (pärast KOH söövitamist) märkimisväärselt, põhjustades kristallide kvaliteedi olulist paranemist. Lisaks näitab TAC-i tiiglis peaaegu null kaalukaotust, säilitab hävitusliku välimuse ja seda saab ringlusse võtta (eluiga kuni 200 tundi), suurendades sellega üksikute kristallide ettevalmistamise protsesside jätkusuutlikkust ja tõhusust.
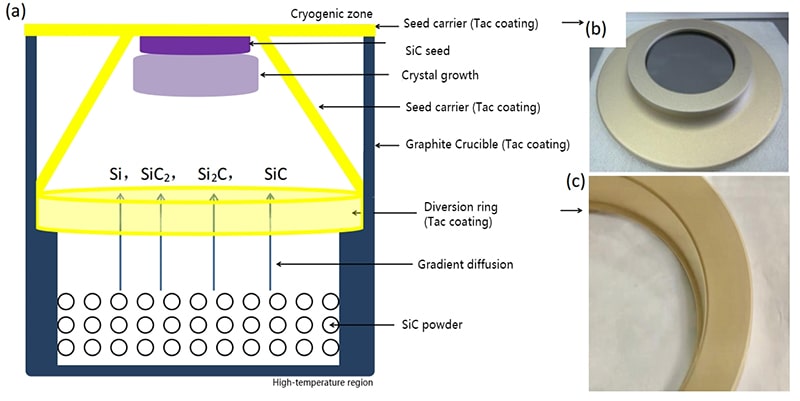
Joonis fig. 2. (a) SIC -i üksikute kristallide valuplokkide kasvatamise seadme skemaatiline diagramm PVT -meetodil
(b) Ülemine TaC-ga kaetud seemneklamber (sealhulgas SiC-seemned)
c) TAC-kattega grafiidist juhtrõngas
MOCVD GAN Epitaksiaalse kihi kasvuküttekeha
Osa/2
MOCVD (Metal-Organic Chemical Vapor Deposition) GaN kasvu valdkonnas, mis on ülioluline meetod õhukeste kilede auruepitaksiaalseks kasvatamiseks metallorgaaniliste lagunemisreaktsioonide kaudu, mängib kütteseade üliolulist rolli täpse temperatuuri reguleerimise ja reaktsioonikambri ühtluse saavutamisel. Nagu on näidatud joonisel 3 (a), peetakse kütteseadet MOCVD-seadmete põhikomponendiks. Selle võime substraati kiiresti ja ühtlaselt kuumutada pikema aja jooksul (sealhulgas korduvad jahutustsüklid), taluda kõrgeid temperatuure (vastupidav gaasikorrosioonile) ja säilitada kile puhtust, mõjutab otseselt kile sadestumise kvaliteeti, paksuse konsistentsi ja laastude jõudlust.
Soojendite jõudluse ja ringlussevõtu tõhususe suurendamiseks MOCVD GaN kasvusüsteemides on TaC-kattega grafiitküttekehade kasutuselevõtt olnud edukas. Erinevalt tavapärastest kütteseadmetest, mis kasutavad pBN-i (pürolüütiline boornitriid) katteid, on TaC-soojenditega kasvatatud GaN-i epitaksiaalsetel kihtidel peaaegu identsed kristallstruktuurid, paksuse ühtlus, sisemiste defektide moodustumine, lisandite doping ja saastumise tase. Lisaks näitab TaC kate madalat takistust ja madalat pinnakiirgust, mille tulemuseks on parem küttekeha efektiivsus ja ühtlus, vähendades seeläbi energiatarbimist ja soojuskadu. Protsessi parameetreid reguleerides saab reguleerida katte poorsust, et veelgi parandada küttekeha kiirgusomadusi ja pikendada selle eluiga [5]. Need eelised teevad TaC-kattega grafiitküttekehadest suurepärase valiku MOCVD GaN kasvusüsteemide jaoks.
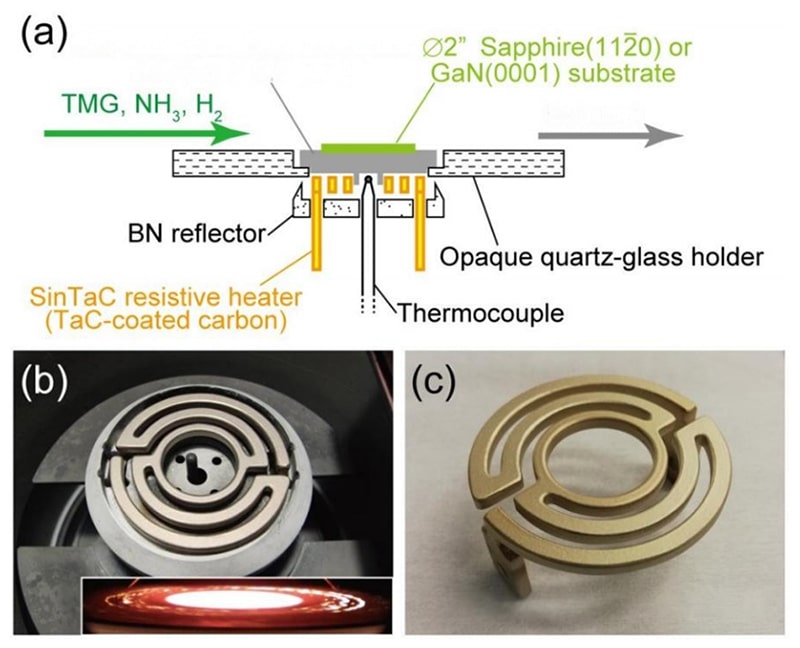
Joonis fig. 3. (a) GAN epitaksiaalse kasvu MOCVD -seadme skemaatiline diagramm
(b) MOCVD-seadistusse paigaldatud vormitud TAC-kattega grafiidiga kütteseade, välja arvatud alus ja sulg (illustratsioon, mis näitab kuumutamisel alust ja sulgu)
c) TAC-kattega grafiidiga küttekeha pärast 17 GAN epitaksiaalset kasvu.
Kaetud sustseptor epitaksia jaoks (vahvelkandja)
Osa/3
Kolmanda klassi pooljuhtide vahvlite nagu SIC, ALN ja GAN valmistamisel kasutatav vahvlikandja, ülioluline konstruktsioonikomponent, mängib olulist rolli epitaksiaalse vahvli kasvuprotsessides. Tavaliselt grafiidist valmistatud vahvli kandja on kaetud SIC -ga, et takistada protsessigaaside korrosiooni epitaksiaalse temperatuuri vahemikus 1100 kuni 1600 ° C. Kaitsekatte korrosioonikindlus mõjutab märkimisväärselt vahvli kandja eluiga. Eksperimentaalsed tulemused on näidanud, et TAC-l on kõrgtemperatuuriga ammoniaagiga kokkupuutel korrosioonikiirus umbes 6 korda aeglasem kui sic. Kõrgtemperatuuriliste vesinikukeskkondades on TAC korrosioonikiirus veelgi rohkem kui 10 korda aeglasem kui SIC.
Eksperimentaalsed tõendid on näidanud, et TAC -ga kaetud alustel on suurepärane ühilduvus sinise valguse GAN MOCVD protsessis ilma lisandite tutvustamata. Piiratud protsesside kohandamise korral näitavad TAC -kandjate abil kasvatatud LED -id võrreldavat jõudlust ja ühtlust tavapäraste SIC -kandjate abil kasvatatud nende suhtes. Järelikult ületab TAC-kattega vahvli kandjate kasutusaega katmata ja SIC-kattega grafiidi kandjate oma.
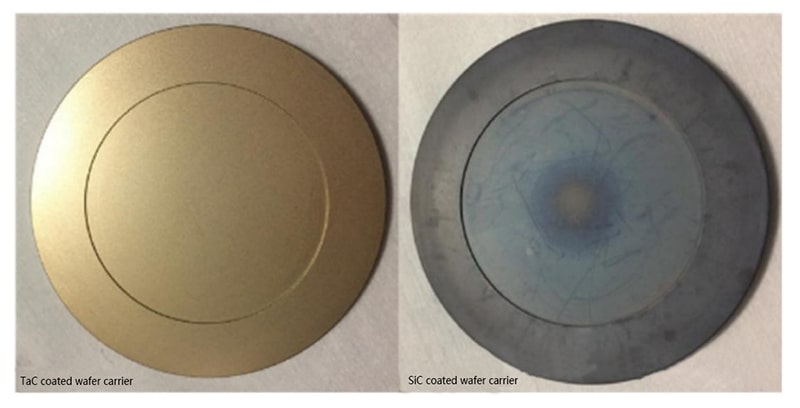
Joonis. Vahvlialus pärast kasutamist GaN epitaksiaalselt kasvatatud MOCVD seadmes (Veeco P75). Vasakpoolne on kaetud TaC-ga ja parempoolne on kaetud SiC-ga.
Tavalise ettevalmistamise meetodTAC -kaetud grafiidiosad
OSA/1
CVD (keemiline aurustamise-sadestamine) meetod:
Temperatuuril 900-2300 ℃, kasutades tantaali- ja süsinikuallikatena TaCl5 ja CnHm, redutseeriva atmosfäärina H2, kandegaasi Ar2, reaktsioonisadestamise kilet. Valmistatud kate on kompaktne, ühtlane ja kõrge puhtusastmega. Siiski on mõned probleemid, nagu keeruline protsess, kallis hind, keeruline õhuvoolu reguleerimine ja madal sadestusefektiivsus.
Osa/2
Läga paagutamise meetod:
Süsinikuallikat, tantaaliallikat, dispergeerivat ainet ja sideainet sisaldav suspensioon kaetakse grafiidile ja paagutatakse pärast kuivatamist kõrgel temperatuuril. Valmistatud kate kasvab ilma korrapärase orientatsioonita, on madala hinnaga ja sobib suuremahuliseks tootmiseks. Tuleb veel uurida, kuidas saavutada ühtlane ja täielik kate suurel grafiidil, kõrvaldada tugidefektid ja suurendada katte sidumisjõudu.
Osa/3
Plasma pihustamise meetod:
TaC pulber sulatatakse kõrgel temperatuuril plasmakaare abil, pihustatakse kiire joaga kõrge temperatuuriga tilkadeks ja pihustatakse grafiitmaterjali pinnale. Oksiidkihti on lihtne moodustada mittevaakumi all ja energiatarve on suur.
TAC -i kaetud grafiidiosad tuleb lahendada
OSA/1
Sidumisjõud:
Soojuspaisumistegur ja muud TAC ja süsinikumaterjalide vahelised füüsikalised omadused on erinevad, katte sidemetugevus on madal, pragude, pooride ja termilise stressi vältimine on keeruline ning kattekihi on hõlpsasti koorida tegelikus atmosfääris, mis sisaldab mädanemist ja mädanemist ja mädanemist sisaldavad atmosfääris. Korduv tõus ja jahutusprotsess.
Osa/2
Puhtus:
TAC-kattekiht peab olema ülitähtsa puhtus, et vältida lisandeid ja reostust kõrgete temperatuuri tingimustes, ning vaba süsiniku ja sisemiste lisandite tõhusad sisustandardid ja iseloomustamisstandardid pinnal ja kogu kattes tuleb kokku leppida.
Osa/3
Stabiilsus:
Kõrge temperatuuritaluvus ja keemilise atmosfääri vastupidavus üle 2300 ℃ on kõige olulisemad näitajad katte stabiilsuse testimiseks. Nõelaugud, praod, puuduvad nurgad ja ühesuunalised terapiirid põhjustavad kergesti söövitavate gaaside tungimist grafiidi sisse ja selle sisse, mille tulemuseks on katte kaitse rike.
OSA/4
Oksüdatsiooniresistentsus:
TAC hakkab oksüdeeruma TA2O5 -ks, kui see on üle 500 ℃, ja oksüdatsiooni kiirus suureneb järsult temperatuuri ja hapniku kontsentratsiooni tõusuga. Pinna oksüdeerimine algab terade piiridest ja väikestest teradest ning moodustab järk -järgult sammaste kristallid ja purustatud kristallid, mille tulemuseks on suur hulk lünki ja auke ning hapniku infiltratsioon intensiivistub kuni katte riisumiseni. Saadud oksiidikihil on halb soojusjuhtivus ja mitmesugused värvid.
OSA/5
Ühtsus ja karedus:
Katte pinna ebaühtlane jaotus võib põhjustada kohalikku termilise pinge kontsentratsiooni, suurendades pragunemise ja säkkimise riski. Lisaks mõjutab pinnakaredus otseselt katte ja väliskeskkonna vastastikmõju ning liiga kõrge karedus põhjustab hõlpsalt suurenenud hõõrdumist vahvli ja ebaühtlase termilise väljaga.
OSA/6
Tera suurus:
Ühtlane terasuurus aitab säilitada katte stabiilsust. Kui tera suurus on väike, ei ole side tihe ning see on kergesti oksüdeeruv ja korrodeeruv, mille tulemuseks on palju pragusid ja auke tera servas, mis vähendab katte kaitsevõimet. Kui tera suurus on liiga suur, on see suhteliselt kare ja kattekihti on termilise pinge all kerge lahti saada.
Järeldus ja väljavaade
ÜldiseltTAC -kaetud grafiidiosadturul on suur nõudlus ja lai valik rakendusvõimalusi, praeguneTAC -kaetud grafiidiosadTootmise põhivool on tugineda CVD TaC komponentidele. Kuid CVD TaC tootmisseadmete kõrge hinna ja piiratud sadestamise efektiivsuse tõttu ei ole traditsioonilisi ränikarbiidiga kaetud grafiitmaterjale täielikult asendatud. Paagutamismeetod võib tõhusalt vähendada toormaterjalide maksumust ja kohaneda grafiitdetailide keeruka kujuga, et rahuldada erinevate rakendusstsenaariumide vajadusi.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi maakond, Jinhua linn, Zhejiangi provints, Hiina
Autoriõigus © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Kõik õigused kaitstud.
Links | Sitemap | RSS | XML | Privaatsuspoliitika |
