QR kood

Meie kohta
Tooted
Võta meiega ühendust


Faks
+86-579-87223657

E-post

Aadress
Wangda Road, Ziyang Street, Wuyi maakond, Jinhua linn, Zhejiangi provints, Hiina
Keemiline mehaaniline poleerimine (CMP) eemaldab liigse materjali ja pinnadefektid keemiliste reaktsioonide ja mehaanilise hõõrdumise koosmõjul. See on võtmeprotsess vahvli pinna globaalse tasapinna saavutamiseks ja on hädavajalik mitmekihiliste vasest ühenduste ja madala k dielektriliste struktuuride jaoks. Praktilises tootmises ei ole CMP täiesti ühtlane eemaldamisprotsess; see põhjustab tüüpilisi mustrist sõltuvaid defekte, millest kõige silmatorkavamad on kihistumine ja erosioon. Need defektid mõjutavad otseselt ühenduskihtide geomeetriat ja nende elektrilisi omadusi.
Dishing viitab suhteliselt pehmete juhtivate materjalide (nt vase) liigsele eemaldamisele CMP ajal, mille tulemuseks on tassikujuline nõgus profiil ühe metalljoone sees või suurel metallpinnal. Ristlõikes asub metalljoone kese selle kahest servast ja ümbritsevast dielektrilisest pinnast madalamal. Seda nähtust täheldatakse sageli laiades joontes, padjandites või plokk-tüüpi metallipiirkondades. Selle moodustumise mehhanism on peamiselt seotud materjali kõvaduse erinevustega ja poleerimispadja deformatsiooniga laiadel metalliosadel: pehmed metallid on lägas olevate keemiliste komponentide ja abrasiivide suhtes tundlikumad ning padja kohalik kontaktrõhk suureneb laiadel osadel, mistõttu eemaldamiskiirus metalli keskel ületab selle servade oma. Selle tulemusena suureneb tassimise sügavus tavaliselt joone laiuse ja ülepoleerimise ajaga.
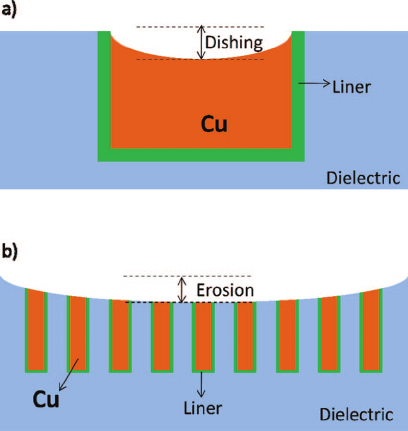
Erosiooni iseloomustab pinna üldkõrgus suure mustriga piirkondades (nagu tihedad metalljoonte massiivid või tiheda näivtäidisega alad) madalam kui ümbritsevates hõredates piirkondades pärast CMP-d. Sisuliselt on see mustri tihedusest lähtuv regiooni tasemel materjali liigne eemaldamine. Tihedates piirkondades annavad metall ja dielektrik koos suurema efektiivse kontaktpinna ning padja ja läga mehaaniline hõõrdumine ja keemiline toime on tugevamad. Järelikult on nii metalli kui ka dielektriku keskmine eemaldamismäär kõrgem kui madala tihedusega piirkondades. Poleerimise ja ülepoleerimise käigus muutub metall-dielektriline virn tihedates piirkondades tervikuna õhemaks, moodustades mõõdetava kõrgusastme ning erosiooniaste suureneb koos lokaalse mustri tiheduse ja protsessi koormusega.
Seadmete ja protsesside toimivuse seisukohalt on kihistumisel ja erosioonil pooljuhttoodetele mitmeid kahjulikke mõjusid. Dishing vähendab metalli efektiivset ristlõikepindala, mille tulemuseks on suurem ühendustakistus ja IR langus, mis omakorda põhjustab signaali viivitust ja ajavaru vähenemist kriitilistel teedel. Erosioonist põhjustatud dielektrilise paksuse kõikumised muudavad metallliinide vahelist parasiitmahtuvust ja RC viivituse jaotust, kahjustades kiibi elektriliste omaduste ühtlust. Lisaks mõjutavad lokaalne dielektriline hõrenemine ja elektrivälja kontsentratsioon metallidevaheliste dielektrikute lagunemiskäitumist ja pikaajalist töökindlust. Integratsiooni tasemel suurendab liigne pinna topograafia litograafia fookuse ja joondamise raskusi, halvendab järgneva kile sadestamise ja söövitamise ühtlust ning võib esile kutsuda defekte, näiteks metallijääke. Need probleemid ilmnevad lõppkokkuvõttes saagikuse kõikumise ja kahaneva protsessiaknana. Seetõttu on praktilises inseneritöös vaja kontrollida tassimist ja erosiooni kindlaksmääratud piirides paigutustiheduse võrdsustamise ja optimeerimise kaudu.poleerimine slutsutamaselektiivsus ja CMP protsessi parameetrite peenhäälestus, et tagada omavahel ühendatud struktuuride tasapinnalisus, stabiilne elektriline jõudlus ja jõuline suuremahuline tootmine.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi maakond, Jinhua linn, Zhejiangi provints, Hiina
Autoriõigus © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Kõik õigused kaitstud.
Links | Sitemap | RSS | XML | Privaatsuspoliitika |
