QR kood

Meie kohta
Tooted
Võta meiega ühendust


Faks
+86-579-87223657

E-post

Aadress
Wangda Road, Ziyang Street, Wuyi maakond, Jinhua linn, Zhejiangi provints, Hiina
FAB -tehases on mitut tüüpi mõõtmisseadmeid. Järgmised on mõned levinud seadmed:
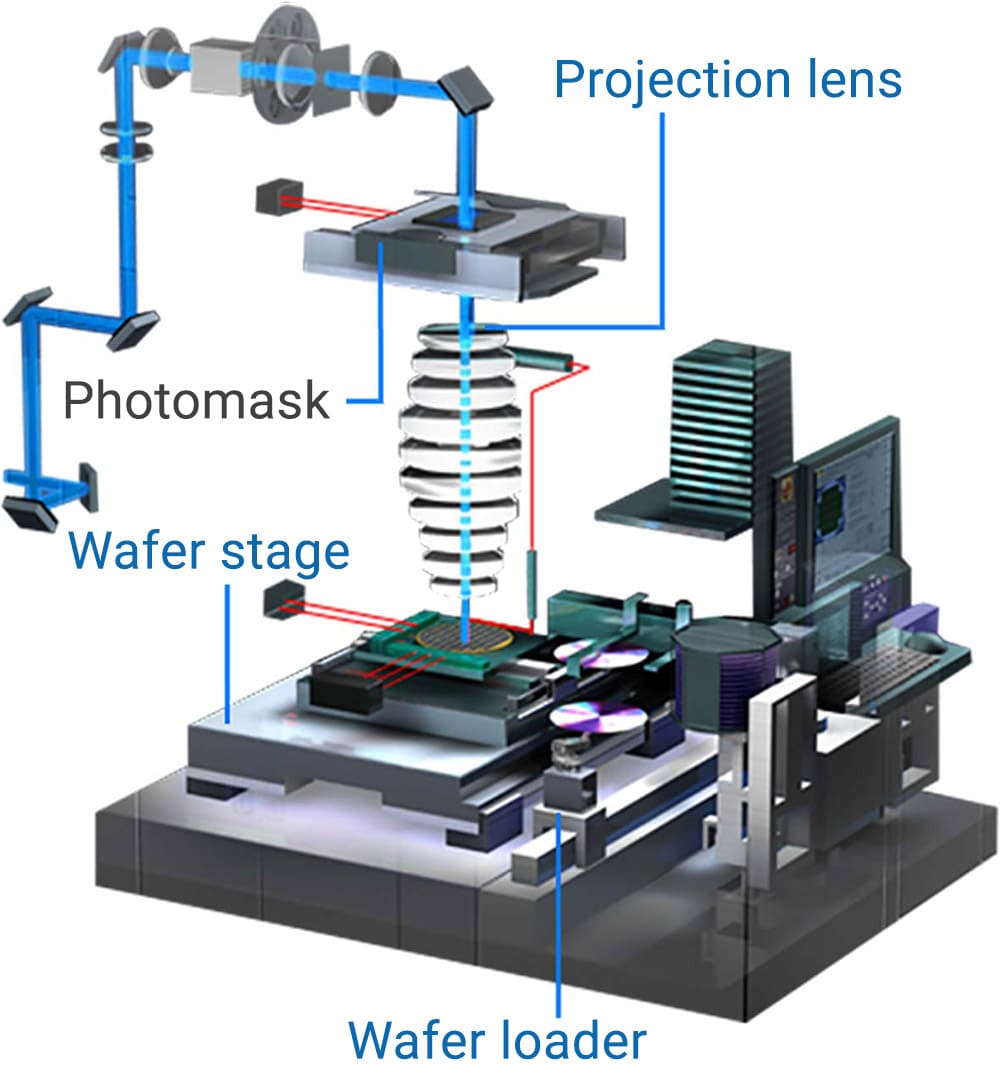
• Fotolitograafia masina joondamise täpsuse mõõtmise seadmed: näiteks ASML -i joondamise mõõtmissüsteem, mis tagab erinevate kihtide mustrite täpse superpositsiooni.
• Fotoresisti paksuse mõõtmisinstrument: Sealhulgas ellipsomeetrid jne, mis arvutavad fotoresisti paksuse valguse polarisatsiooni omadustel.
• ADIT ja AEI tuvastamise seadmed: Tuvastage fotoresistide arendamise efekt ja mustri kvaliteet pärast fotolitograafiat, näiteks VIP optoelektroonika vastavad tuvastusseadmed.
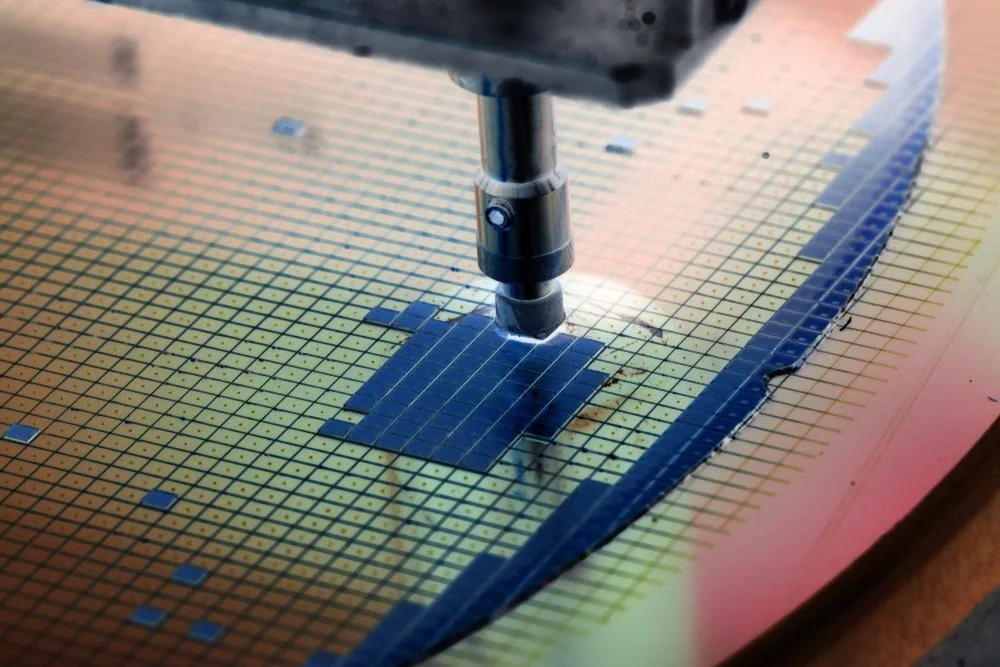
• Soovimise sügavuse mõõtmise seadmed: nagu valge valguse interferomeeter, mis suudab täpselt mõõta söövitussügavuse väikseid muutusi.
• Profiilide mõõtmisinstrumendi söövitus: Elektronitala või optilise pildistamise tehnoloogia kasutamine profiiliteabe mõõtmiseks, näiteks mustri külgseina nurk pärast söövitamist.
• CD-SEM: saab täpselt mõõta mikrostruktuuride, näiteks transistoride suurust.

• kile paksus mõõteriistad: Optilised peegeldumeetrid, röntgenikiirguse peegeldumeetrid jne võivad mõõta erinevate vahvli pinnale ladestunud kilede paksust.
• kile stressi mõõtmisseadmed: Mõõtes kile tekitatud stressi vahvli pinnal, hinnatakse filmi kvaliteeti ja selle võimalikku mõju vahvli jõudlusele.
![]()
• ioonide implantatsiooni annuse mõõteseadmed: Määrake ioonide implantatsiooni annus, jälgides selliseid parameetreid nagu kiirte intensiivsus ioonide implantatsiooni ajal või tehakse vahvlil pärast implanteerimist.
• dopingu kontsentratsioon ja jaotuse mõõteseadmed: Näiteks saavad sekundaarsed ioonmassispektromeetrid (SIMS) ja levimiskindlad sondid (SRP) mõõta vahvli dopinguelementide kontsentratsiooni ja jaotust.
![]()
• Polistavusejärgse mõõtmise seadmed: Vahvli pinna mõõtmiseks pärast poleerimist kasutage optilisi profilomeetreid ja muid seadmeid.
• Poleerimise eemaldamise mõõteseadmed: Määrake poleerimise ajal eemaldatud materjali kogus, mõõtes märgi sügavuse või paksuse muutumist vahvli pinnal enne ja pärast poleerimist.
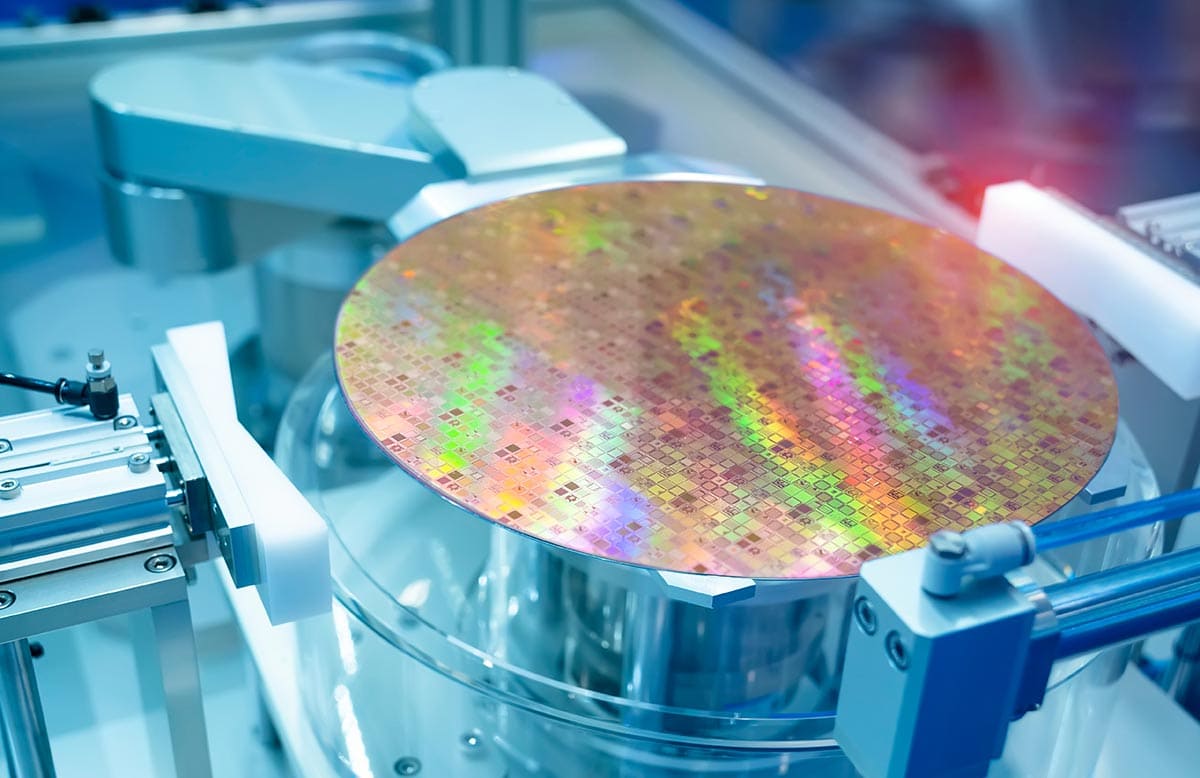
• KLA SP 1/2/3/5/7 ja muud seadmed: suudab tõhusalt tuvastada osakeste saastumist vahvli pinnal.
• Tornado sari: VIP -optoelektroonika tornaado seeria seadmed võivad tuvastada selliseid defekte nagu osakesed vahvlil, genereerida defektkaarte ja tagasisidet nendega seotud protsessidele reguleerimiseks.
• Alfa-X intelligentsed visuaalse kontrolli seadmed: Kasutage CCD-AI pildi juhtimissüsteemi kaudu nihke- ja visuaalse sensori tehnoloogiat, et eristada vahvli pilte ja tuvastada selliseid defekte nagu osakesed vahvli pinnal.
Muud mõõteseadmed
• optiline mikroskoop: kasutatakse vahvli pinna mikrostruktuuri ja defektide jälgimiseks.
• Skaneeriv elektronmikroskoop (SEM): võib pakkuda kõrgema eraldusvõimega pilte vahvli pinna mikroskoopilise morfoloogia jälgimiseks.
• Aatomjõu mikroskoop (AFM): saab mõõta selliseid teavet nagu vahvli pinna karedus.
• ellipomeeter: Lisaks fotoresisti paksuse mõõtmisele saab seda kasutada ka selliste parameetrite, näiteks õhukeste kilede paksuse ja murdumisnäitaja mõõtmiseks.
• Neljatundiline tester: kasutatakse elektriliste jõudluse parameetrite mõõtmiseks, näiteks vahvli takistus.
• röntgendifraktomeeter (XRD): suudab analüüsida vahvli materjalide kristallstruktuuri ja stressiseisundit.
• Röntgenifotoelektroni spektromeeter (XPS): Kasutatakse vahvli pinna elementaarse koostise ja keemilise oleku analüüsimiseks.
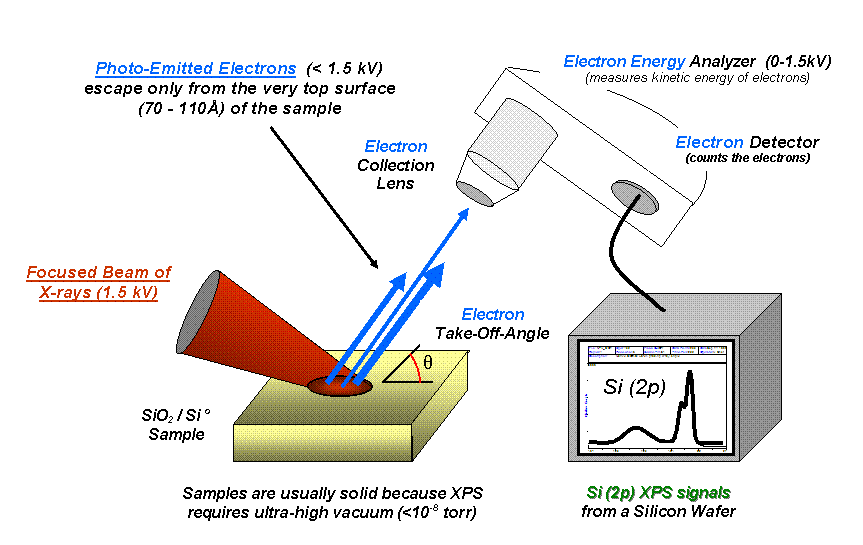
• Fookustatud ioonkiire mikroskoop (FIB): saab teha vahvlite mikro-nano töötlemist ja analüüsi.
• Macro ADI seadmed: nagu ringmasin, mida kasutatakse mustri defektide makrode tuvastamiseks pärast litograafiat.
• Maski defektide tuvastamise seadmed: tuvastage maski puudused, et tagada litograafiamustri täpsus.
• Käigukasti elektronmikroskoop (TEM): võib jälgida mikrostruktuuri ja defekte vahvli sees.
• Traadita temperatuuri mõõtmise vahvli andur: Sobib mitmesugusteks protsessiseadmeteks, mõõtes temperatuuri täpsust ja ühtlust.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi maakond, Jinhua linn, Zhejiangi provints, Hiina
Autoriõigus © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Kõik õigused kaitstud.
Links | Sitemap | RSS | XML | Privaatsuspoliitika |
