QR kood

Meie kohta
Tooted
Võta meiega ühendust


Faks
+86-579-87223657

E-post

Aadress
Wangda Road, Ziyang Street, Wuyi maakond, Jinhua linn, Zhejiangi provints, Hiina
Looduses on kristalle kõikjal ning nende levik ja rakendamine on väga ulatuslikud. Ja erinevatel kristallidel on erinevad struktuurid, omadused ja ettevalmistamise meetodid. Kuid nende ühine tunnus on see, et kristalli aatomid on regulaarselt paigutatud ja konkreetse struktuuriga võre moodustub seejärel perioodilise virnastamise kaudu kolmemõõtmelises ruumis. Seetõttu on kristallmaterjalide välimus tavaliselt regulaarne geomeetriline kuju.
Räni karbiidi üksikkristalli substraadimaterjal (edaspidi SIC substraadiks) on ka omamoodi kristalsed materjalid. See kuulub laia ribalapi pooljuhtide materjalidele ja sellel on kõrge pingetakistuse, kõrge temperatuuri takistuse, kõrge sageduse, madala kadu jne eelised.
SIC on IV-IV ühendi pooljuhtmaterjal, mis koosneb süsinikust ja ränist stöhhiomeetrilise suhtega 1: 1 ja selle kõvadus on teine ainult teemandist.
Nii süsiniku kui ka räni aatomitel on 4 valentselektroni, mis võivad moodustada 4 kovalentset sidet. SIC -kristalli SIC tetraeedri põhistruktuurne üksus tekib tetraeedrilisest sidemest räni ja süsinikuaatomite vahel. Nii räni kui ka süsinikuaatomite koordinatsioonide arv on 4, st igal süsinikuaatomil on selle ümber 4 räni aatomit ja igal räni aatomil on ka 4 süsinikuaatomit.
Kristallmaterjalina on SIC substraadil ka aatomkihtide perioodilise virnastamise omadus. SI-C diatomilised kihid on virnastatud mööda [0001] suunas. Tavaliste polütüüpide hulka kuulub 2H-SIC, 3C-SIC, 4H-SIC, 6H-SIC, 15R-SIC jne. Nende hulgas nimetatakse virnastamisjärjestust "ABCB" järjekorras 4H Polytype. Ehkki SIC erinevatel polütüüpidel on sama keemiline koostis, on nende füüsikalised omadused, eriti ribalaiuse laius, kandja liikuvus ja muud omadused üsna erinevad. Ja 4H polütüütina omadused sobivad paremini pooljuhtide rakenduste jaoks.

2H-SIC

4H-SIC

6H-SIC
Kasvuparameetrid, nagu temperatuur ja rõhk, mõjutavad märkimisväärselt 4H-SIC stabiilsust kasvuprotsessi ajal. Seetõttu tuleb üksikute kristallmaterjali saamiseks kõrge kvaliteediga ja ühtlusega parameetreid nagu kasvutemperatuur, kasvurõhk ja kasvukiirus täpselt kontrollida valmistamise ajal.
Praegu on räni karbiidi ettevalmistamismeetodid füüsikalise auru transpordimeetod (PVT) , kõrge temperatuuriga keemiline aurude sadestamise meetod (HTCVD) ja vedela faasi meetod (LPE). Ja PVT on peavoolumeetod, mis sobib tööstuslikuks masstootmiseks.
![]()
a) PVT kasvumeetodi visand SIC Bouli ja
(b) PVT kasvu 2D visualiseerimine, et kujutada suurepäraseid üksikasju morfoloogia ja kristallide kasvu liidese ja tingimuste kohta
PVT kasvu ajal asetatakse SIC -seemnekristall tiigli ülaossa, samal ajal kui lähtematerjal (SIC pulber) asetatakse põhja. Kõrge temperatuuri ja madalrõhuga suletud keskkonnas sublimatiseerib SIC pulber ja seejärel transpordib temperatuuri gradiendi ja kontsentratsiooni erinevuse mõjul seemne lähedal asuvasse ruumi ülespoole. Ja see kristallib pärast üleküllastunud olekusse jõudmist. Selle meetodi abil saab juhtida SIC kristalli suurust ja polütüüpe.
Kuid PVT -meetod nõuab kogu kasvuprotsessis sobivate kasvutingimuste säilitamist, vastasel juhul põhjustab see võrehäiret ja moodustab soovimatuid puudusi. Lisaks on SIC kristallide kasv lõpule viidud suletud ruumis, millel on piiratud jälgimismeetodid ja palju muutujaid, seega on protsessi kontroll keeruline.
SIC -kristallide kasvatamise protsessis PVT -meetodil peetakse ühekristallide moodustamiseks peamiseks mehhanismiks astmevoolu kasvu. Aurustatud SI ja C aatomid seovad eelistatavalt aatomitega aatomitega sammudel ja koonustes, kus need tuuma ja kasvavad, nii et iga samm voolab paralleelselt edasi. Kui kasvupinna iga etapi laius on palju suurem kui adsorbeeritud aatomite difusioonivaba tee, võib suur arv adsorbeeritud aatomeid aglomeerida ja moodustada kahemõõtmelise saare, mis hävitab astmevoolu kasvurežiimi, mille tulemuseks on muude polütüüpide moodustamine 4H. Seetõttu on protsessiparameetrite reguleerimise eesmärk kontrollida astmestruktuuri kasvupinnal, et vältida soovimatute polütüüpide moodustumist ja saavutada eesmärk saada 4H ühekristallstruktuur ja lõpuks valmistada kvaliteetseid kristalle.
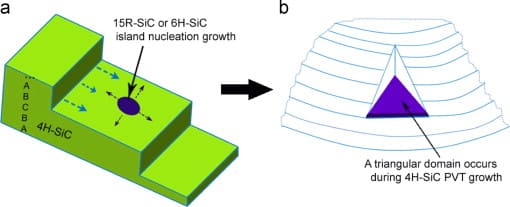
SIC ühekristalli astmevoolu kasv
Kristalli kasv on vaid esimene samm kvaliteetse SIC substraadi valmistamiseks. Enne kasutamist peab 4H-SIC valuplok läbima rea protsesse nagu viilutamine, lammutamine, kaldus, poleerimine, puhastamine ja kontrollimine. Kõva, kuid rabeda materjana on SIC -i üksikkristallil ka vahvli sammude jaoks kõrged tehnilised nõuded. Igal protsessis tekitatud kahjudel võib olla teatav pärilikkus, ülekandumine järgmisele protsessile ja lõpuks mõjutada toote kvaliteeti. Seetõttu köidab SIC substraadi tõhus vahvertehnoloogia ka tööstuse tähelepanu.



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi maakond, Jinhua linn, Zhejiangi provints, Hiina
Autoriõigus © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Kõik õigused kaitstud.
Links | Sitemap | RSS | XML | Privaatsuspoliitika |
