QR kood

Meie kohta
Tooted
Võta meiega ühendust


Faks
+86-579-87223657

E-post

Aadress
Wangda Road, Ziyang Street, Wuyi maakond, Jinhua linn, Zhejiangi provints, Hiina
Iga pooljuhttoote tootmine nõuab sadu protsesse ja kogu tootmisprotsess jaguneb kaheksaks etapp:vahvli töötlemine - oksüdatsioon - fotolitograafia - söövitus - õhuke kilede sadestamine - ühendus - testimine - pakend.
![]()
1. samm:Vahvli töötlemine
Kõik pooljuhtide protsessid algavad liivateraga! Kuna liivas sisalduv räni on vahvlite tootmiseks vajalik tooraine. Vahvlid on ümmargused viilud, mis on lõigatud räni (SI) või galliumraseniidist (GAAS) valmistatud üksikkristallsilindritest. Kõrgpuhustusega ränimaterjalide eraldamiseks on vaja ränidioksiidi liiva, spetsiaalset materjali, mille ränidioksiidi sisaldus on kuni 95%, mis on ka vahvlite valmistamise peamine tooraine. Vahvli töötlemine on ülaltoodud vahvlite valmistamise protsess.
Valuvalamine
Esiteks tuleb liiva kuumutada, et eraldada selles sisalduv süsinik ja räni, ning protsessi korratakse, kuni saadakse ülikõrge puhtus elektroonilise kvaliteediga räni (nt-Si). Kõrgpuhustusega räni sulab vedelaks ja tahkestub seejärel ühe kristall tahkeks vormiks, mida nimetatakse "vangiks", mis on pooljuhtide tootmisel esimene samm.
Räni valuplokkide (räni sambad) tootmise täpsus on väga kõrge, ulatudes nanomeetri tasemele ja laialdaselt kasutatav tootmismeetod on Czochralski meetod.
Valuploki lõikamine
Pärast eelmise etapi lõpuleviimist on vaja teemantsaegaga valuploki kaks otsa ära lõigata ja seejärel lõigata see teatud paksusega õhukesteks viiludeks. Vihma läbimõõt määrab vahvli suuruse. Suuremaid ja õhemaid vahvleid saab jagada kasutatavateks ühikuteks, mis aitab vähendada tootmiskulusid. Pärast räni valuvajutuse lõikamist on vaja lisada viiludele "lameda pindala" või "denta" märgid, et hõlbustada töötlemissuuna määramist standardina järgmistes etappides.
Vahvli pinna poleerimine
Ülaltoodud lõikeprotsessi kaudu saadud viilusid nimetatakse "paljaste vahvliteks", see tähendab töötlemata "toorvahveriteks". Palja vahvli pind on ebaühtlane ja vooluahela mustrit ei saa sellele otse printida. Seetõttu on vaja pinna defektid kõigepealt eemaldada lihvimis- ja keemiliste söövitusprotsesside abil, seejärel poleerida sileda pinna moodustamiseks ja seejärel puhastamise kaudu eemaldades jääksaasteained, et saada valmis vahvlit puhta pinnaga.
2. samm: oksüdatsioon
Oksüdatsiooniprotsessi roll on vahvli pinnale kaitsekile moodustamine. See kaitseb vahvli keemiliste lisandite eest, hoiab ära lekkevoolu vooluringi sisenemise, takistab difusiooni ioonide implanteerimise ajal ja takistab vahvli libisemist söövitamise ajal.
Oksüdatsiooniprotsessi esimene samm on lisandite ja saasteainete eemaldamine. Orgaaniliste ainete, metalli lisandite ja jääkvee aurustamiseks on vaja nelja sammu. Pärast puhastamist saab vahvli paigutada kõrge temperatuuriga keskkonda 800–1200 kraadi Celsiuse ja ränidioksiid (s.o "oksiid") kiht moodustatakse hapniku või auru vooluhulgaga vahvli pinnale. Hapnik hajub läbi oksiidikihi ja reageerib räniga, moodustades erineva paksusega oksiidikihi, ja selle paksust saab mõõta pärast oksüdatsiooni lõppu.

Kuiv oksüdatsioon ja niiske oksüdatsioon Sõltuvalt erinevatest oksüdatsioonireaktsioonis oksüdeerijatest saab termilise oksüdatsiooniprotsessi jagada kuivaks oksüdatsiooniks ja niiskeks oksüdatsiooniks. Esimene kasutab ränidioksiidi kihi tootmiseks puhast hapnikku, mis on aeglane, kuid oksiidikiht on õhuke ja tihe. Viimane nõuab nii hapnikku kui ka väga lahustuvat veeaur, mida iseloomustab kiire kasvukiirus, kuid suhteliselt paks kaitsekiht, millel on madala tihedusega.
Lisaks oksüdeerijale on ka muid muutujaid, mis mõjutavad ränidioksiidikihi paksust. Esiteks mõjutavad vahvli struktuur, selle pinnadefektid ja sisemine dopingukontsentratsioon oksiidikihi tekete teket. Lisaks sellele, mida suurem on oksüdatsiooniseadmete tekitatud rõhk ja temperatuur, seda kiiremini genereeritakse oksiidikiht. Oksüdatsiooniprotsessi ajal on vaja kasutada ka mannekeenilehte vastavalt vahvli asukohale, et kaitsta vahvlit ja vähendada oksüdatsiooni astme erinevust.
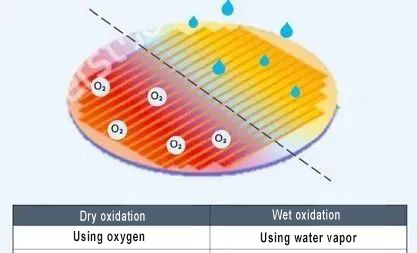
3. samm: fotolitograafia
Fotolitograafia on vooluringi mustri "printimine" valguse kaudu. Saame sellest aru kui pooljuhtide tootmiseks vajaliku lennukikaardi joonistamist vahvli pinnale. Mida suurem on vooluahela mustri peenus, seda suurem on valmis kiibi integreerimine, mis tuleb saavutada täiustatud fotolitograafia abil. Täpsemalt, fotolitograafia võib jagada kolmeks etapiks: fotoresisti katmine, kokkupuude ja areng.
Kate
Esimene samm vooluringi vahvlile joonistamiseks on fotoresisti katmine oksiidikihil. Fotoresist teeb vahvli "fotopaberiks", muutes selle keemilisi omadusi. Mida õhem on vahvli pinnal oleva fotoresisti kiht, seda ühtlasem on kattekiht ja seda peenemat on muster, mida saab trükkida. Seda sammu saab teha meetodil "Spin kattes". Vastavalt valguse (ultraviolettkiirguse) reaktsioonivõime erinevusele võib fotoresistid jagada kahte tüüpi: positiivne ja negatiivne. Esimene laguneb ja kaob pärast valgusega kokkupuudet, jättes paljastamata ala mustri, teine aga polümeriseerub pärast valguse kokkupuudet ja paneb paljastatud osa mustri ilmuma.
Kokkupuude
Pärast seda, kui fotoresistist kile on vahvlil kaetud, saab vooluahela printimise lõpule viia, juhtides valguse kokkupuudet. Seda protsessi nimetatakse "kokkupuuteks". Saame valikuliselt valgust läbi viia kokkupuuteseadme kaudu. Kui valgus läbib vooluahela mustrit sisaldavat maski, saab vooluahela trükkida alloleva fotoresisti kilega kaetud vahvlile.
Kokkupuuteprotsessi ajal on seda peenemas trükitud muster, seda rohkem komponente mahutab lõplik kiip, mis aitab parandada tootmise tõhusust ja vähendada iga komponendi kulusid. Selles valdkonnas on uus tehnoloogia, mis praegu palju tähelepanu köidab, EUV litograafia. LAM -i uurimisrühm on ühiselt välja töötanud uue kuiva filmi fotoresisti tehnoloogia koos strateegiliste partnerite ASML ja IMEC -ga. See tehnoloogia võib oluliselt parandada EUV-litograafia kokkupuuteprotsessi tootlikkust ja saaki, parandades eraldusvõimet (see on peenhäälestamise vooluahela laiuse võtmetegur).
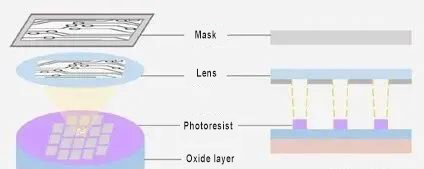
Arendamine
Pärast kokkupuudet on samm arendaja pihustamine vahvlile, eesmärk on eemaldada fotoresist mustri katmata piirkonnas, nii et trükitud vooluahela mustrit saab paljastada. Pärast arenduse lõpuleviimist tuleb seda kontrollida erinevate mõõteseadmete ja optiliste mikroskoopidega, et tagada vooluahela diagramm.
4. samm: söövitus
Pärast seda, kui vooluringi skeemi fotolitograafia on vahvlil lõpule viidud, kasutatakse söövitusprotsessi mis tahes liigse oksiidkile eemaldamiseks ja ainult pooljuhtide vooluringi skeem. Selleks kasutatakse valitud liigsete osade eemaldamiseks vedelikku, gaasi või plasmat. Sõltuvalt kasutatavatest ainetest on kaks peamist söövitusmeetodit: märg söövitus, kasutades spetsiifilist keemilist lahust oksiidkile eemaldamiseks keemiliseks reageerimiseks, ja kuiva söövitamist gaasi või plasma abil.
Märg söövitus
Märg söövitus, kasutades keemilisi lahuseid oksiidkilede eemaldamiseks, on odavate, kiire söövituskiiruse ja suure tootlikkusega eelised. Märg söövitus on aga isotroopne, see tähendab, et selle kiirus on igas suunas sama. See põhjustab maski (või tundlikku kilet) mitte täielikult joondatud söövitatud oksiidkilega, seetõttu on keeruline töödelda väga peeneid vooluahelate skeeme.

Kuiv söövitus
Kuiva söövitus võib jagada kolme erinevat tüüpi. Esimene neist on keemiline söövitus, mis kasutab söövitusgaase (peamiselt vesinikfluoriidi). Nagu märg söövitus, on see meetod isotroopne, mis tähendab, et see ei sobi peene söövitamiseks.
Teine meetod on füüsiline pritsimine, mis kasutab ioone plasmas, et mõjutada ja eemaldada liigne oksiidikiht. Anisotroopse söövitusmeetodina on pritsimisel söövitamisel horisontaalses ja vertikaalses suundades erinev söövitussagedus, seega on selle peenus ka parem kui keemiline söövitus. Selle meetodi puuduseks on aga see, et söövitamiskiirus on aeglane, kuna see sõltub täielikult ioonide kokkupõrkest põhjustatud füüsilisest reaktsioonist.
Viimane kolmas meetod on reaktiivne ioonide söövitus (RIE). RIE ühendab kaks esimest meetodit, see tähendab, et kasutades ionisatsiooni füüsiliseks söövitamiseks plasmat, viiakse keemiline söövitus läbi pärast plasma aktiveerimist genereeritud vabade radikaalide abil. Lisaks kahele esimesele meetodile ületavale söövituskiirusele saab RIE kasutada ioonide anisotroopseid omadusi, et saavutada kõrgeim mustri söövitus.
Tänapäeval on peenete pooljuhtide vooluahelate saagise parandamiseks laialdaselt kasutatud kuiva söövitamist. Täisjuhise söövitus ühtluse ja suureneva söövitamiskiiruse säilitamine on kriitiline ning tänapäeva kõige arenenumad kuivad söövitusseadmed toetavad kõige arenenumate loogika- ja mälukiipide tootmist suurema jõudlusega.

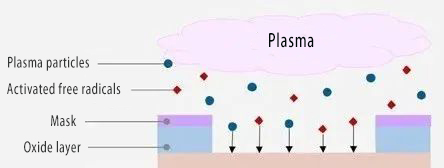
Vetek Semiconductor on Hiina professionaalne tootjaTantaalkarbiidikate, Räni karbiidikate, Spetsiaalne grafiit, Räni karbiidi keraamikajaMuud pooljuhtide keraamika. Vetek Semiconductor on pühendunud täiustatud lahenduste pakkumisele erinevatele SIC -vahvlite toodetele pooljuhtide tööstusele.
Kui olete huvitatud ülaltoodud toodetest, võtke meiega otse ühendust.
Mob: +86-180 6922 0752
WhatsApp: +86 180 6922 0752
E -post: anny@veteksemi.com



+86-579-87223657


Wangda Road, Ziyang Street, Wuyi maakond, Jinhua linn, Zhejiangi provints, Hiina
Autoriõigus © 2024 WuYi TianYao Advanced Material Tech.Co.,Ltd. Kõik õigused kaitstud.
Links | Sitemap | RSS | XML | Privaatsuspoliitika |
